化工过程智能分析
近红外光谱仪通过实时采集物料光谱数据,结合化工专用算法模型,快速解析反应进程、混合物成分及关键指标(如水分、溶剂残留、混合均匀度等)。实验室设备为工艺开发提供高精度基准,在线设备嵌入产线实时反馈数据至控制系统,动态调节温度、流量、阀门等参数,形成“检测-分析-控制”闭环管理,实现生产全程标准化与资源最优化。





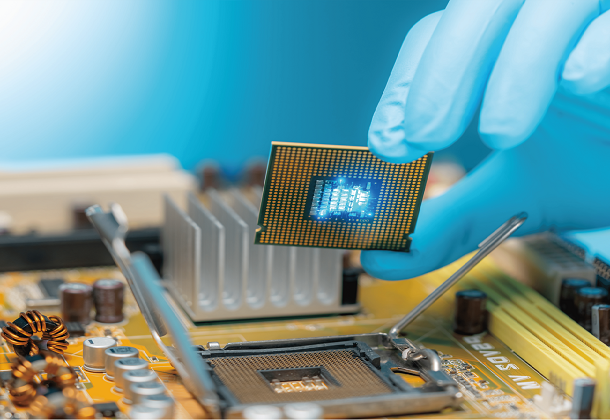















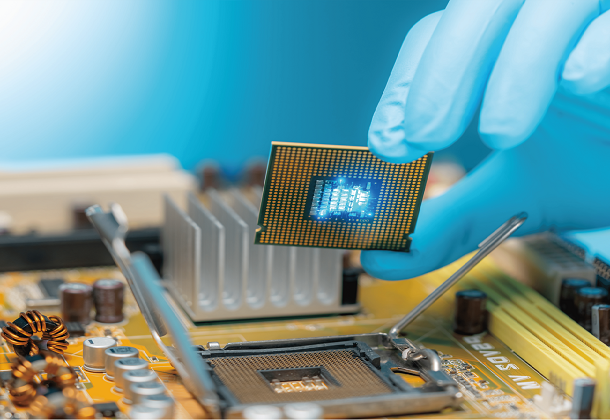















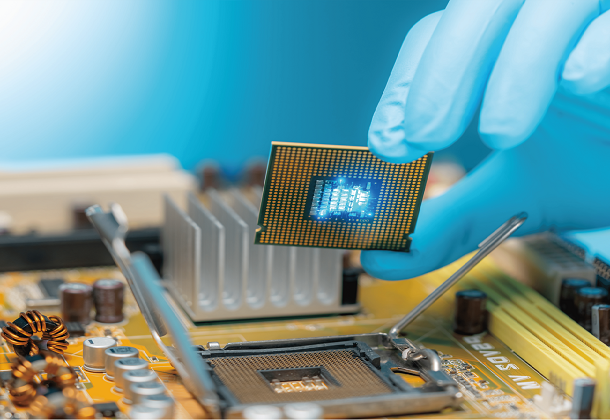





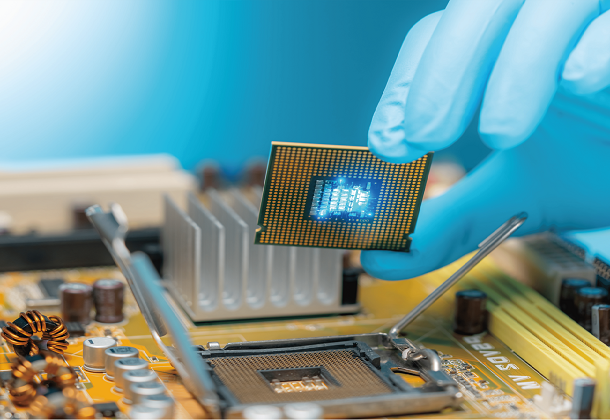





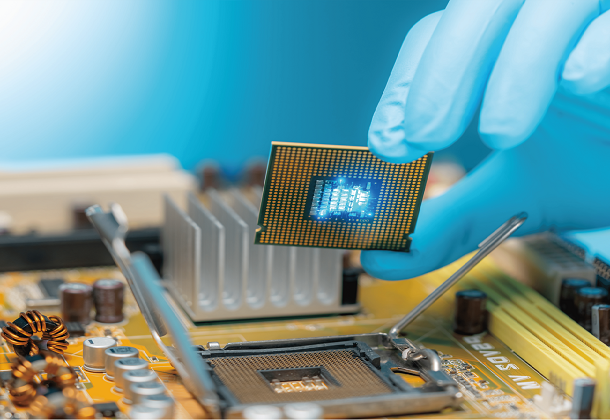

Jun
2025

化学药液浓度计是RCA清洗工艺的关键监控装置,通过实时跟踪各类溶液的成分变化,确保各清洗阶段化学配比处于最佳工作区间。该设备能够精确感知溶液活性组分的微小偏差,及时触发补液或稀释操作,防止因浓度波动引发的清洗不彻底或基材损伤。其持续监测功能有效维持了药液在重复使用中的稳定性,减少生产中断频率。同时,自动化的浓度管理降低了人工取样检测的潜在误差,提升了工艺一致性和可重复性。浓度计的数据输出为清洗流程优化提供了科学依据,对于保障高端半导体器件的良率和性能具有重要意义。

